您现在的位置是:首页 > 电气技术 > 电气技术
功率集成电路PIC概述
![]() 来源:艾特贸易2017-11-10
来源:艾特贸易2017-11-10
简介功率集成电路 (Power Integrated Circuit) ,是把控制电路和大功率器件都集成在同一块芯片上的高度集成电路。使得电路的可靠性增加、体积减小、质量减轻,是器件发展的一个方向。 PIC 制
功率集成电路(Power Integrated Circuit),是把控制电路和大功率器件都集成在同一块芯片上的高度集成电路。使得电路的可靠性增加、体积减小、质量减轻,是器件发展的一个方向。
PIC制造过程中的主要问题是高压和低压器件之间的绝缘及发热处理。PIC和高压集成电路( HVIC)通常有所区别,后者电压很高,但是电流很小,也就是说损耗很小。低压NMOS、CMOS和双极型器件可以很方便地和MOS栅极大功率器件集成。目前已有的PIC包括了电力MOSFET和IGBT智能开关、半桥逆变器传动、H桥逆变器、两相步进电动机传动、直流电动机传动所用的单象限斩波器、三相无刷直流电动机传动等。图3 33为一块用来驱动无刷直流电动机的单片PIC(在虚线框内)。这个40V、2A的PIC的简化框图包括一个6个功率开关,霍尔传感器解码逻辑、下级开关的电流调节PWM(脉宽调制)控制,以及热保护和欠电压保护功能。

图3-33 一块用来驱动无刷直流电动机(BLDC)的单片PIC(Unitrode UC3620)
智能功率模块(IPM)是先进的混合集成功率器件,由高速、低耗的IGBT芯片和优化的门极驱动及保护电路构成。由于采用了能连续监测功率器件电流的有电流传感功能的IGBT芯片,从而实现高效的有过电流保护和短路保护。由于IPM集成了过热和锁定保护电路,系统的可靠性得到进一步提高。设计和开发智能功能模块产品的主导思想是为应用装置的生产厂家降低在设计、开发和制造上的成本,与普通IGBT相比,在系统性能和可靠性上进一步提高,使设计和开发更简单。由于IPM集成了驱动和保护电路,使产品设计变得相当容易,缩短产品上市的时间。自动化的IPM组装和测试手段提高了系统的可靠性,同时还减少了采购、存储和组装的元件数。由于IPM通态损耗和开关损耗都比较低,使得散热器减小,因而系统尺寸也减小。所有的IPM均采用同样的标准化与逻辑电平控制电路相连的栅控接口,在产品系列扩充时无需另行设计驱动电路。IPM在故障情况下的自保护能力,降低了器件在开发和使用中发生过载时的受损机率。
三菱电机在1991年11月首次推出全系列智能功率模块。此后在功率芯片、封装和控制电路技术上不断改进后推出第三代IPM。第三代智能功率模块是为低开关损耗的应用而设计的,以满足市场对工作频率在20kHz以上的静音型变频器的需求。
智能功率模块采用了许多在IGBT模块中已得到验证的功率模块隔离封装技术。由于采用了两种不同的封装技术使得内置的栅驱动电路和保护电路能适用的电流范围很宽,同时使造价维持于合理水平。小功率器件采用一种多层环氧树脂粘合绝缘系统,而中、大功率器件采用陶瓷绝缘。IPM有四种电路形式,有单管封装(H)、双管封装(G)、六合一封装(R),如图3-34所示。

图3-34 电路结构
多层环氧树脂粘合结构:小功率IPM(10~50A,600V和10~15A,1200V)采用一种基于多参层环氧树脂粘合的绝缘系统。在这一系统中,铜层和环氧树脂直接在铝基板上构成屏蔽的印制线路。功率芯片和栅驱动电路元件直接焊在基板上面,需另置印制线路板和陶瓷绝缘材料。采用这种技术制成的模块封装费用比较低。这种封装设计非常适合应用于讲究低成本和紧凑尺寸的消费类工业产品上。图3-35所示是这种1PM封装的横截面。
中、大功率IPM采用陶瓷绝缘材料结构。在这些模块中,采用铜箔直接键合(DBC)技术,即铜箔不用焊料,直接键合到陶瓷衬底上面。这样的衬底结构可为大功率器件提供更好的散热特性和更大的载流容量。栅驱动电路和控制电路则包含在功率器件上面另一块单独的PCB上。而这块PCB带有特殊防电磁干扰保护层。

图3-35 多层粘合结构图
1-壳;2-环氧树脂;3-输入信号端子;4-硅塑胶;5-集成电路;6-IGBT;
7-FWD芯片;8-键合引线;9-多层基板铜箔直接键合结构
图3-36所示是一智能功率模块的结构。
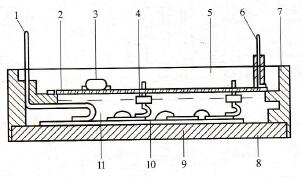
图3-36 智能功率模块的结构
1-主电路端子;2-控制电路PCB;3-集成电路;4-内连接体;5-环氧树
脂;6-信号端子;7-外壳;8-基板;9-IGBT芯片;10-陶瓷绝缘层;
11-硅塑胶
点击排行
 室内风扇电机和霍尔元件的检测
室内风扇电机和霍尔元件的检测