您现在的位置是:首页 > 电气技术 > 电气技术
绝缘栅双极型晶体管(IGBT)简介
![]() 来源:艾特贸易2017-11-10
来源:艾特贸易2017-11-10
简介绝缘栅双极型晶体管 (InsulatedGate Bipolar Transistor) 出现在 20 世纪 80 年代初期,它是一种三端电力电子开关器件,用于控制电能。在这以前,在高频中小功率应用领域中广泛使用的是前面
绝缘栅双极型晶体管(InsulatedGate Bipolar Transistor)出现在20世纪80年代初期,它是一种三端电力电子开关器件,用于控制电能。在这以前,在高频中小功率应用领域中广泛使用的是前面提到的双极型电力晶体管( BJT)和金属氧化物电力场效应晶体管(MOSFET)。门极关断晶闸管因开关速度较低,而不适合于高频应用。虽然电力BJT有很好的通态特性,但它的开关时间较长,特别是关断过程。这两种都是电流控制型器件,但电流增益小,这是因为对于高阻断能力的器件,要求高的注入效应和宽的基区宽度,以防止电压穿通。因此,它们就需要较为复杂的基极驱动电路,以便在通态期间为基极提供合适的电流,可这又增加了控制极的功率损耗。另一方面,电力MOSFET是电压型器件,在开关期间只需很小的控制电流。因而栅极驱动电路的要求相对简单。MOSFET有极高的开关速度。可是,当电压超过200V时,MOSFET的单极性质就产生了不良的通态特性。而且,随着击穿电压的升高,通态电阻增大。此外,其固有的体二极管呈现了差的反向。恢复特性,从而导致更大的开关损耗。
IGBT将类似于电力MOSFET的绝缘栅输入结构和低通态电阻的电力BJT结构的优点组合在一起,就改善了电力电子器件的性能。而采用上述两种器件结构以达林顿接法构造的器件如图3-23所示,其性能优于两种器件中任一种分立器件的性能。这种混合器件可以用和电力MOSFET相同的方式来控制,且具有低的通态电阻,这是因为大部分输出电流是通过BJT处理的。因为BJT的电流增益很小,所以就需要一个同一数量级的MOSFET来构成它的驱动器。集MOS栅极控制和双极型电流导通特性的最大好处于一体的最有效方法是将MOSFET和BJT原理统一用于同一半导体区。这一种新观念的提出,就可以得到具有优越通态性能、开关速度高和大安全工作区的商用IGBT。与MOS-FET相比较,没有集成体二极管的IGBT,既是优点也是缺点,它主要取决于实际电路对开关速度和电流的要求。对于某些特定应用,可以采用外加快恢复二极管或在同一封装内加装一个二极管的方法加以解决。由于IGBT的导通耗很少,所以在高压应用领域中,IGBT正在取代MOSFET,与电力BJT相比,IGBT有很高的开关频率、类似的通态压降和电流密度。虽然IGBT有很快的开通速度,但因其电流下降时间很长,致使其关断速度比MOS-FET慢。而且,在相同额定功率条件下,IGBT所用的硅面积要比MOSFET小。因此在高压应用领域,用IGBT代替MOSFET改善了效率,降低了价格。另外,IGBT还可以叫做电导调制场效应管.(COMFET)、绝缘栅晶体管和双极型MOSFET。
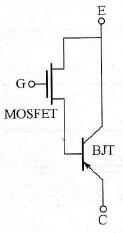
图3-23 MOSFFF和BJT的混合达林顿结构
由于软开关电路拓扑表现出比硬开关电路拓扑更多的优点,因此它在工业中的应用不断增多。通过使用软开关技术,IGBT的工作频率可以高达几百千赫兹。然而IGBT在软开关和硬开关情况下的工作状态是不同的。因此在择选器件时,主要考虑的是软开关电路和硬开关电路的不同。在大功率变换器中使用的IGBT,常遭受高的瞬态电应力,如短路或带有钳位感性负载的关断。因此,在高应力的条件下,IGBT的耐受能力是一个重要的问题。一般情况下,器件的制造厂商和电力电子电路的设计者之间存在一定的相互制约的关系。所以,只有在实际电路中使用后,才会发现有关器件可靠性方面的缺陷。这明显减慢了电力电子系统优化的过程。尽管如此,如果在设计阶段将全部有关器件的性能和可靠性问题都考虑到,则研发时间将显著地缩短。在电路应用中,高应力状态是极为常见的。在这些条件下,采用模拟IGBT性能的方法是既省钱而又合适的。然而只有恰当地理解了在电路施加应力下的器件工作原理后,才能去开发这种模型。实现上,根据制造工艺和器件仿真来优化IGBT是一种既快捷又经济的方法。图3-24给出了一个IGBT等效电路及图形符号。

图3-24 IGBT等效电路及符号
(a) IGBT等效电路;(b)图形符号
由图3-24可以看出,IGBT的结构和MOSFET基本相似,不同之处是它在MOSFET集电极的N+耗尽层上增加了一个P+层。该器件具有MOSFET的高输入阻抗,但又有类似BJT的导通特性。如果栅极对射极的电压为正,那么在P区就会产生一个N沟道。它使PNP晶体管的基极一发射极PN结正向偏置,导致晶体管导通并引起N-区电导率的改变,从而得到远低于MOSFET的导通压降。
在导通时,IGBT等效电路中的驱动MOSFET承载着总输出电流中的大部分。通过充分降低P+层的电阻率和把大部分电流转移到MOSFET中,可以防止寄生NPN晶体管引起的类似晶闸管擎住作用。该器件的关断是通过把栅极电压降低到零或负,从而关闭P区的导电沟道来实现的。该器件比BJT或MOSFET具有更高的电流密度。其输入电容( CISS)远远小于MOSFET。同样,栅极一集电极电容和栅极一发射极电容之比也较低,从而使得Miller效应有所改善。
图3-25给出了在饱和区域附近的IGBT的伏安特性,由此可以看出其类似BJT的特性。现代IGBT使用沟槽栅(Trench-gate)技术来进一步降低导通压降。该器件没有表现出任何BJT的二次击穿特性,其方形SOA像MOSFET一样受发热限制。因此,IGBT变流器的设计中可以有缓冲器,也可以没有。

图3-25 IGBT的伏安特性(600V,150A)
点击排行
 室内风扇电机和霍尔元件的检测
室内风扇电机和霍尔元件的检测